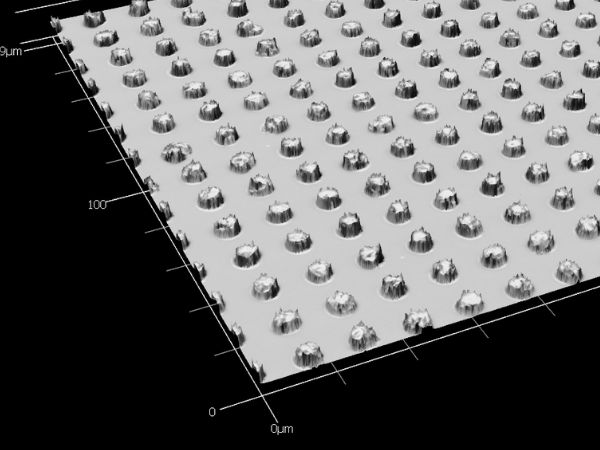
Indium Bump Interconnect (IBI) Flip Chip Bonding
Eine wachsende Zahl an Pixeln und Qubits sowie eine steigende Verbindungsdichte auf immer größeren Chips treiben Hybridisierung und monolithische Integration voran. Umso bedeutsamer werden zuverlässige Lösungen für das Fine Pitch Micro Indium Bump Interconnect (IBI) Flip Chip Bonding.